我们的包装专家正在寻找跨制造商和技术,以及
我们积极探索最大的消费电子市场,寻找创新和颠覆性的半导体封装事件。当破坏性事件发生时,我们会对其进行分析和报告。
我们的分析涵盖了英特尔、三星、美光、苹果等市场领导者。它涵盖了各种设备类型,如处理器(微型、图形、应用程序)、相机模块、内存等。
我们的专家正在探索和揭示前沿包装技术,如:
- 包内系统(SiP)和包上系统(PoP)
- 扇入(FI)和扇出(FO)晶圆级封装(WLP)
- 2.5D和3D包装
- 电源封装
- 图像传感器封装
TechInsights发布技术分析已有30多年的历史,使我们的客户能够提高他们的知识产权和产品战略。例如:
最近的报告摘要
- 三星Exynos 9110 FO-PLP-三星的下一代半导体封装技术(ACE-1810-803)
- Micron Technology MT43A4G40200NFA-S15 ES:一种混合存储立方体Gen 2 3D封装和TSV(ACE-1810-801)
- Intel SR3RM第8代四核i5-8305G处理器,带Radeon RX Vega M GL GPU(编号:ACE-1804-804)
除了出版以封装为重点的报告外,TechInsights还拥有全球最大的半导体技术分析数据库。我们对我们广泛分析的每一个设备进行拍照,包括包装和横截面图像。我们保存了数十万张与包装技术和材料相关的图片。
高密度扇出封装技术——检验和比较
原始日期:2019年4月9日/美国东部时间下午2:00至下午3:00
主持人:米歇尔·罗伊
搜索我们的分析和网站
| 相关分析 | 制造商. | 分析类型 | 订阅频道 |
|---|---|---|---|
| Analyst Briefing: Packaging - Process - 2020 12 | 系统 | 高级包装-工艺 | |
| 英特尔SRH4U Foveros 3D PoP技术高级封装软件包 | 英特尔 | 过程 | 高级包装-工艺 |
| GaN GS66508B / GS66508T嵌入式模具包装先进的包装要领 | GAN系统 | Packaging | 高级包装-工艺 |
| 高通公司QET5100M Advanced Packaging Essentials | 高通公司 | Packaging | 高级包装-工艺 |
| Samsung 9820 Application Processor PoP with Interposer Technology Advanced Packaging Essentials | Samsung | Packaging | 高级包装-工艺 |
| 苹果A12X高级包装精华 | 苹果 | Packaging | 高级包装-工艺 |
| 高通公司PM8150高级包装软件包 | 高通公司 | Packaging | 高级包装-工艺 |
| 三星Exynos 9110三星扇形输出面板级封装-高级封装要素 | Samsung | 过程 | 高级包装-工艺 |
| Micron Technology MT43A4G40200NFA-S15 ES:一种混合存储立方体第2代(HMC2)3D封装,带TSV-高级封装 | 微米技术 | 过程 | 高级包装-工艺 |
| 英特尔SR3RM HBM2 EMIB ACMOS Essentials - 先进包装 | 英特尔 | 过程 | 高级包装-工艺 |
最近的新闻和博客

网络研讨会:为电动车(EV)革命而准备
加入我们,2021年2月3日,星期三网络研讨会:为电动汽车(EV)革命做好准备美国东部时间下午3点先进的电力设备和点播2021年2月3日,星期三下午3点在线研讨会注册JST和点播2021年2月3日,星期三
03
2月

支持半导体行业的知识产权战略
支持半导体行业的知识产权战略芯片市场的日益复杂使得知识产权所有者比以往任何时候都更难监控发展,使得逆向工程成为一个关键的过程——逆向工程的广度raybet正规么
27
简

在苹果新的激光雷达相机中发现的索尼d-ToF传感器
2021年1月19日图像传感器颠覆性技术索尼d-ToF传感器在苹果新的激光雷达相机中发现苹果的激光雷达相机在2020年的iPad Pro中首次被观测到;正如预期的那样,我们在10月份看到了iPhone 12 Pro中使用的相同部件。工业
19
简

Hisilicon向天线转向调制解调器解决方案 - 移动RF TechStream博客
2021年1月12日John Sullivan Hisilicon向天线转向调制解调器解决方案Hisilicon为华为的移动手机提供了RF收发器和移动SoC,但RF前端传统上是从通常的前端采购
12
简

英特尔推出2nd-Gen 3D XPoint内存,在IEDM - Memory Techstream Blog讨论
2020年12月28日Dick James Intel发布第二代3D XPoint Memory,12月16日在IEDM上讨论Intel举行了“内存与存储时刻”,宣布了五款新的内存和存储产品;两款Optane™ SSD,一个用于数据中心,另一个用于
28
12月

东芝集成二极管到SiC MOSFET-电源TechStream博客
2020年12月21日斯蒂芬罗素东芝集成二极管到碳化硅MOSFET每个碳化硅(SiC)制造商似乎有自己的方法来制造场效应管。无论是平面、沟道、JFET等,整个系统都没有主导设计
21
12月
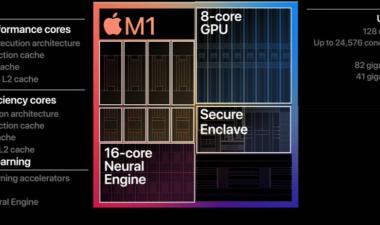
Analysis of Apple M1 is Happening – and, Thermal Imaging?
Dick James是一位近50年的半导体行业资深人士,从事半导体器件的工艺开发、设计、制造、封装和逆向工程。迪克是一个经常投稿的人raybet正规么
21
12月


两个新的苹果soc,两个市场事件:苹果A14和M1
可用逻辑订阅>工艺和高级封装>工艺流程>晶体管特性>SoC设计分析>数字平面图分析>分析-数字平面图>标准单元GDS库分析>晶体管
16
12月


网络研讨会:USB-C电源交换机中的新兴GaN技术
USB-C电源传输适配器中的新兴GaN技术本次活动由Sinjin Dixon Warren和TechInsights介绍,具有USB连接的电源适配器在现代生活中无处不在。我们使用的移动设备需要定期连接
09
12月

3D闪存,176层!
So far, NAND Flash has shown a white-hot stage. Not long ago, storage vendors were still "seeing the scenery on the high platform of flash memory" with 128 layers.
09
12月
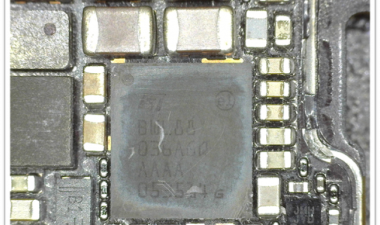
无线充电加速-拆卸TechStream博客
高级技术分析师Stacy Wegner Stacy Wegner是TechInsights拆卸部门的高级技术分析师,负责确保我们的分析师提供的高技术数据转化为具有竞争力的消费品
08
12月

网络研讨会:2020年及以后的内存技术-NAND、DRAM、新兴和嵌入式内存技术趋势
2020年及以后的存储技术NAND, DRAM, Emerging and Embedded Memory Technology Trends This webinar was presented by TechInsights In this webinar, Dr. Jeongdong Choe will present his detailed review of the latest NAND, DRAM, emerging and
02
12月

网络研讨会:对苹果iphone12的技术和财务影响的研究
考察苹果iPhone 12的技术和财务影响本文由TechInsights介绍了TechInsights和Bloomberg Intelligence分析师,因为它们分享了对苹果最多的技术和财务见解
10
十一月

STMicroelectronics MasterGaN1内部集成GAN高压半桥-TechStream Power Semiconductor博客
Sinjin Dixon Warren,高级工艺分析师Sinjin Dixon Warren是TechInsights的高级工艺分析师,拥有超过20年的半导体分析经验,是电力电子分析的主题专家(SME)。他拿着一个
03
十一月
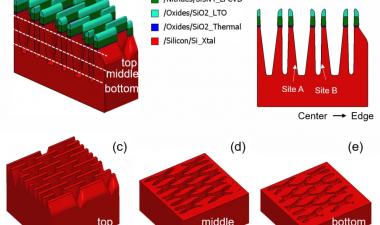

网络研讨会:商用存储设备中的ALD/ALE过程
2018年商用存储设备中的ALD/ALE工艺见证了存储产品制造商三星(Samsung)、海力士(Hynix)、东芝(Toshiba)和美光(Micron)推出64层或72层堆叠的3D-NAND设备,并进入1x代DRAM设备。本演示文稿将
28
十月

10月苹果:苹果iPhone 12箴拆卸——茶rdown TechStream Blog
高级技术分析师Stacy Wegner Stacy Wegner是TechInsights拆卸部门的高级技术分析师,负责确保我们的分析师提供的高技术数据转化为具有竞争力的消费品
26
十月

iPhone相机历史:iphone12的另类与普通
iPhone相机的进化史也可以看作是手机CIS的发展史,即使iPhone没有完全跟随CIS技术的潮流前进。只是抓住这个机会,还要通过最后一次
21
十月

来自Micron-Memory-TechStream博客的新GDDR6X
Jeongdong Choe博士是TechInsights的高级技术研究员,在DRAM、(V)NAND、SRAM和逻辑器件的半导体工艺集成方面拥有近30年的经验。他定期提供博客
15
十月
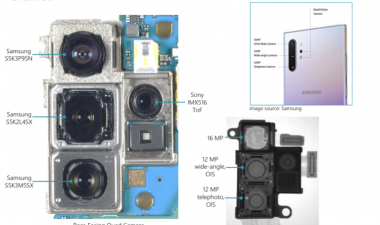
意法半导体在Galaxy Note系列中取代索尼ToF-图像传感器TechStream博客
Ray Fontaine,图像传感器产品经理Ray是世界上杰出的图像传感器技术专家之一,他定期为TechInsights订户发布图像传感器分析内容和评论。2020年10月11日三星
11
十月

一名新的球员在GaN充电器市场出现 - Innoscience Inn650D02发现在Rh-PD65W USB-C充电器内部
作者:sinjindixonwarren博士在USB-C充电器中出现氮化镓(GaN)技术是半导体市场的一个新趋势。在过去的一年里,TechInsights从纳维教育和Power找到了GaN技术
08
十月
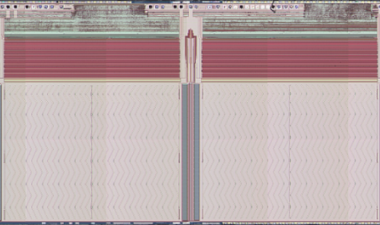
快速查看三星128L(136T)3D V-NAND - Memory Techstream Blog
Jeongdong Choe博士是TechInsights的高级技术研究员,在DRAM、(V)NAND、SRAM和逻辑器件的半导体工艺集成方面拥有近30年的经验。他定期提供博客
08
十月

UnitedSiC用他们的SiC JFET技术走了一条少人走过的路-电力半导体TechStream博客
Sinjin Dixon Warren,高级工艺分析师Sinjin Dixon Warren是TechInsights的高级工艺分析师,拥有超过20年的半导体分析经验,是电力电子分析的主题专家(SME)。他拿着一个
08
十月

Avalanche 40 nm pmtj stt-mram- Memory TechStream Blog
Jeongdong Choe博士是TechInsights的高级技术研究员,在DRAM、(V)NAND、SRAM和逻辑器件的半导体工艺集成方面拥有近30年的经验。他定期提供博客
25
九月
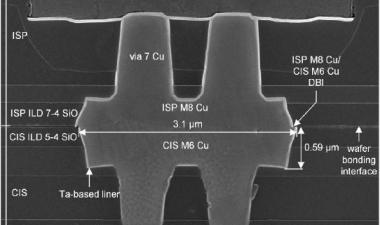
混合键合从图像传感器扩展到逻辑、内存-图像传感器、逻辑和内存TechStream博客
Dick James是一位近50年的半导体行业资深人士,从事半导体器件的工艺开发、设计、制造、封装和逆向工程。迪克是一个经常投稿的人raybet正规么
25
九月

网络研讨会:空间、电源、光束——缩短长途跋涉,在5G收发机设计和制造方面取得优势
空间,动力,梁缩短艰巨,以获得5g收发器设计的边缘,移动射频景观已经变得更具竞争力,引进了5克,辅以相关创新旨在解决各种各样的创新
23
九月
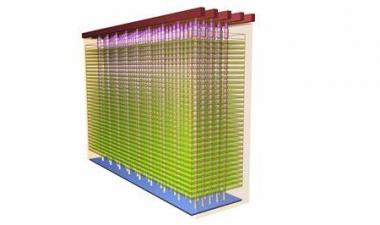
DRAM, 3D NAND Face New Challenges
Semiconductor Engineering - Various memories and business outlooks are all over the map, sometimes literally, with lots of confusion ahead.
21
九月

SK hynix 128L 3D PUC NAND(4D NAND)
skhynix发布了世界上第一个128层(128L)3D NAND,他们称之为4D NAND。这是他们的第二代NAND使用外围下单元(PUC)架构构建;第一代是他们的96L NAND。在PUC架构中,外围设备
14
九月

Intel RealSense L515激光雷达相机内部
简介激光雷达传感的世界正在发展。旋转转台激光雷达在自动驾驶等应用中很常见(请参阅我们的汽车激光雷达拆卸订阅),但它们正被新一代固态激光雷达所取代
11
九月

网络研讨会:商用逻辑器件中的ALD/ALE过程
2018年商用逻辑器件的ALD/ALE工艺推出了新一代逻辑产品,其特点是以Intel为主打的finFET晶体管及其10nm代微处理器,随后是TSMC和三星
26
八月

三星S5K33D i-ToF,带7µm像素全局快门-图像传感器TechStream博客
Ray Fontaine,图像传感器产品经理Ray是世界上杰出的图像传感器技术专家之一,他定期为TechInsights订户发布图像传感器分析内容和评论。2020年8月12日我们的团队
12
八月

60年的半导体行业及其改变专利战略
Contributed by: Arabinda Das Today the semiconductor industry is a behemoth whose annual sales revenue crosses US $400 Billion. Over its 60 years of existence, this mature industry has experimented with various models like integrated device
04
八月
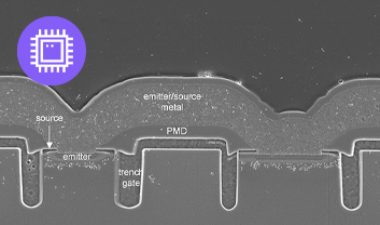

记忆过程Webinar: 3D NAND Word Line Pad (WLP)
美国东部时间2020年6月24日星期三下午2:00主持:Chi Lim Tan 3D NAND(垂直NAND)凭借其更高的密度和更低的每比特成本,一直是固态硬盘(SSD)普及的驱动力,这得益于创新和持续发展
24
六月
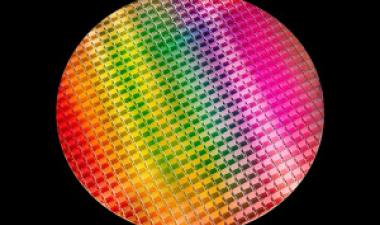
英特尔10nm节点:过去、现在和未来——第2部分
有些人说,在2017年的H2 - H1 2018 TimeFrame Intel的10nm节点是如此烘焙,该英特尔必须显着重新设计其10 NM工艺技术的后续产品。无论如何,一个SKU和有限的可用性为自己说话。
17
六月

Apple计算机:过渡到ARM Chips即将推出
Quand on dit ce mois-ci, c’est à l’occasion de la Conférence des développeurs qui se tiendra dans la semaine du 22 juin, un événement très important appelé WWDC ou Worldwide Developers Conference qui se tient en Californie, à San José ou à San
11
六月
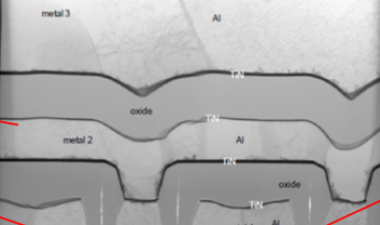
再论APA光学GaN-HEMT的开创性专利
发布时间:2020年6月5日供稿人:辛金·迪克森·沃伦博士电力电子行业正处于转型期。多年来,硅基器件一直占据着行业的主导地位,传统的硅MOSFET晶体管被用于较低的成本
05
六月

松下在专利货币化方面的专长从未如此重要
Like many other businesses, the Japanese heavyweight is under significant financial pressure thanks to the covid-19 pandemic, but its long track record of leveraging its IP assets could prove a saving grace
05
六月

点播网络研讨会:GaN电力设备生态系统和IP景观回顾
美国东部时间2020年5月27日,星期三下午2:00,主持人:Sinjin Dixon Warren电力电子行业正处于转型期。多年来,硅基器件一直占据着工业的主导地位,传统的硅MOSFET晶体管被用于制造半导体
27
五月

有效NAND专利调查指南
由于波形和协议测试对于调查内存技术专利的使用证据至关重要,TechInsights的Martin Bijman和Neil MacLeod仔细研究了顶级NAND专利所有者的投资组合,以确定它们之间的区别
21
五月

Unlocking the Secrets of the YMTC 64-Layer 3D Xtacking® NAND Flash
介绍YMTC的第二代3D-NAND技术,它使用“XTacking”与内存阵列面对面绑定外围电路而不是旁边。如在半导体摘要中发表的。
08
五月
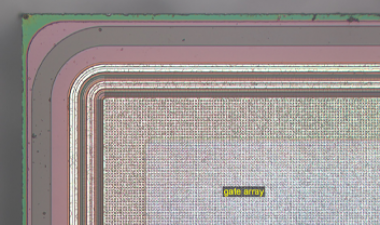
SIC电源晶体管工艺流程分析:RoHM SCT30222ALGC11工艺流程
供稿作者:辛金迪克森沃伦碳化硅(SiC)功率晶体管市场预计将在未来几年大幅增长。与传统的硅基器件相比,SiC功率晶体管有几个优点,包括
05
五月

专利组合管理:2020年的有效策略和最佳实践
4月29日 - 12:00-1:30 PM(et) - Live Webinar,“专利组合管理:由知识组托管的”专利组合管理:2020年的有效策略和最佳实践“。主要主题包括:专利组合管理趋势和发展,是一个重要的
29
四月

选择合适的专利软件以获得更好的效果
市场上从来没有这么多IP工具和技术助手,但是您如何决定哪些工具和技术助手对您的业务有帮助?TechInsights的Martin Bijman解释道。
29
四月

Qualcomm Snapdragon SDR865收发器分析;支持5G Sub-6 GHz和LTE服务
Snapdragon 865平台是高通公司迄今为止最先进的5G芯片组,支持5G、sub-6、mmWave和LTE。4G/5G动态频谱共享,将使“运营商能够利用其现有的4G频谱资源加速5G部署。”
27
四月

看看苹果A12Z芯片上的仿生系统
苹果A12Z仿生SoC只是A12X的更名版,有启用的GPU内核吗?当我们第一次在实验室得到苹果ipadpro2020 A2068时,这是我们想知道的第一件事。什么是A12Z?当我们看到A12Z时,在视觉上看不到
15
四月
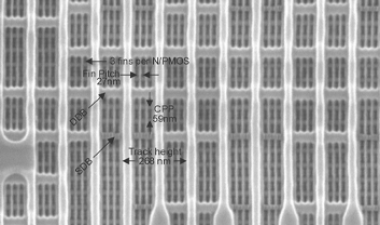
TechInsights在三星Exynos 990中证实了三星真正的7LPP工艺
去年,三星宣布在Exynos 9825中使用的7LPP工艺中引入EUV。通过对零件的分析,我们发现9825的7LPP工艺和Exynos 9820的8LPP工艺差别不大。现在,我们
18
三月

YMTC是中国第一家大规模生产3D NAND闪存芯片的公司
撰稿人:Choongdong最初发表于3月12日,修订于2020年4月7日TechInsights终于在中国武汉找到了由扬子存储科技有限公司(YMTC)制造的3D Xtacking®NAND设备。有了这个设备,YMTC
12
三月

三星Galaxy S20超级5G摄像头拆除
贡献作者:Ray Fontaine祝贺三星团队不仅提供了一个井规格的相机系统,而且还要首先使用0.7μm的生成像素!2019年9月宣布的GH1堆积成像仪正在
04
三月

三星Galaxy S20 Ultra 5G拆解分析
供稿作者:Daniel Yang,Ray Fontaine在TechInsights的实验室里特别忙。就在我们开始拆卸小米10旗舰系列(全球首款高通Snapdragon 865)的各种型号的几天后
04
三月

最近分析三星移动射频组件
Shannon 5800 55M5800A01 As the industry expands its use of 5G, Samsung continues to innovate in the area of mobile communication technologies, including RF transceivers and phased array solutions for mmWave along with 5G-embedded mobile processors
03
三月

如果说苹果受到了冠状病毒的伤害,那么它的供应商和竞争对手可能也会受到影响
苹果公司(Apple Inc.)出人意料地警告称,由于冠状病毒(coronavirus)的流行,该公司可能无法实现本季度的销售目标,这对其芯片和其他供应商以及同样依赖中国生产产品的竞争对手来说,都是一个很大的痛点。
18
2月

Recent MediaTek Mobile RF Components and Analysis
MT6303P AN10516CW 2.95 x 1.74-180nm移动射频架构的复杂性不断增加,以支持多种标准,我们在几乎每一款新手机中都发现了新的移动射频组件。在撰写本文时
15
简

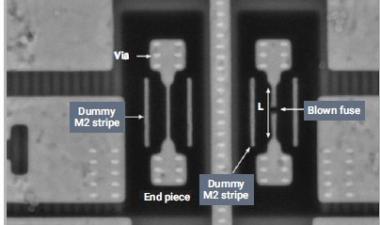



华为Mate 30 Pro 5G拆解:卖6399元整机,BOM成本仅2799元
According to agency analysis, the 4G version is Huawei's first smartphone product without US parts, while the 5G version still uses some American-made components, the proportion is ...
30
12月

华为Mate30 Pro 5G深度拆解:来自日本的2000多个组件
From the BOM table, the estimated price of the whole machine is $ 395.71, equivalent to less than 2800 yuan, of which the main control chip accounts for about 51.9% of the whole machine price.
26
12月

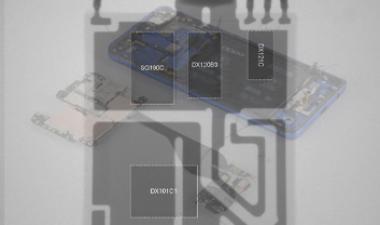
Power Integrations与他们的Powigan技术进行了oem设计胜利
Posted: December 12, 2019 Contributing Authors: Sinjin Dixon-Warren, PhD Consumer demand for smaller form factor and higher power, plus government efficiency regulations, are driving innovation in the USB adapter market. The USB-C power delivery
12
12月
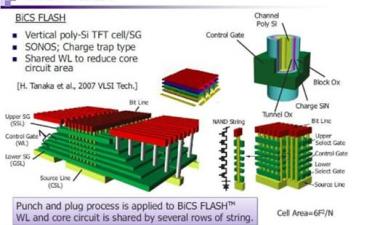
东芝WD联盟3D NAND量产将采用三星TCAT工艺
集微网消息(文/Yuna),据Impress Watch网站报道,东芝在12月8日 召开的IEDM会议上声明在3D NAND闪存量产中采用类似于三星TCAT的存储单元结构。
12
12月
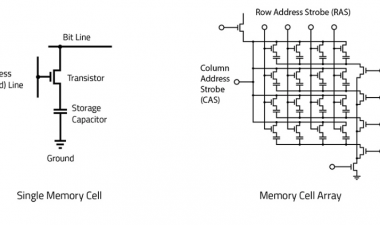

彗星湖桌面将出现在2020年2月左右?英特尔CPU路线图
TechInsights于10月31日发布了名为“英特尔核心I7-1065G7”冰湖“10 NM 2ND Gen处理器分析”的摘要报告。
18
十一月
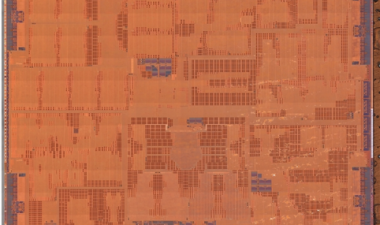
麒麟990 5G核心数据曝光:113.31平方毫米集成103亿晶体管
近日,华为发布了新款5G手机Mate 30 5G系列。其麒麟990 5G SoC的性能非常令人兴奋。近日,专业芯片研究机构TechInsights拆除了这款商用5G集成SoC芯片。
12
十一月

苹果U1-延迟芯片及其可能性
发布时间:2019年11月8日供稿作者:Stacy Wegner Figure 1:Apple U1 UWB芯片iPhone11中最吸引人的组件之一就是神秘的芯片Apple简单地贴上了“U1”的标签。TechInsights一直在忙着对此进行分析
08
十一月

华为Mate 30 Pro 5G拆卸
介绍麒麟990 5G发布时间:2019年11月7日供稿作者:Daniel Yang,Stacy Wegner华为Mate 30系列是公司年度旗舰智能手机的最新一期,于2019年9月19日在慕尼黑发布
07
十一月

提示网络研讨会:分析NAND Flash和SSD设备的技术
日期:2019年11月6日/美国东部时间下午3:00至4:00由Neil MacLeod和Marty Bijman介绍内部探测、波形分析和更多数据中心的广泛采用和扩展将SSD市场推向了一个高度竞争和竞争的时期
06
十一月
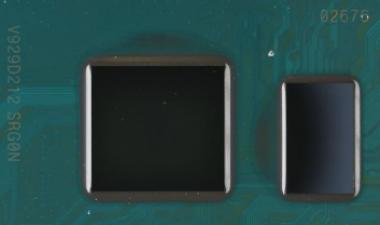
英特尔酷睿i7-1065G7“冰湖”10nm第二代处理器分析
英特尔在消费类产品中发布了首款10nm第二代处理器——英特尔酷睿i7-1065G7处理器,俗称“冰湖”。戴尔和微软已经宣布在他们的一些最新产品中加入冰湖。这个
31
十月

SIC MOSFET技术的演变:回顾性
发布时间:2019年10月31日投稿作者:新津迪克森沃伦碳化硅(SiC)是一种广泛使用的工业材料。碳化硅公司在1893年发现艾奇逊工艺后开始大规模生产
31
十月
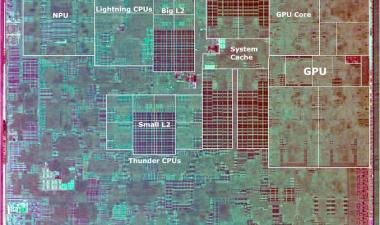
The Apple iPhone 11, 11 Pro & 11 Pro Max Review: Performance, Battery, & Camera Elevated
TechInsights现在正式发布了新款苹果A13的一个模版,我们可以证实我们这边的一些假设。
27
十月
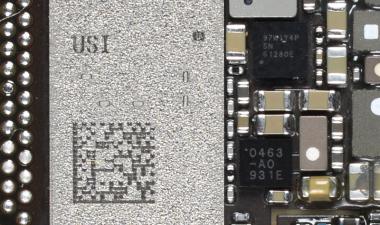
Apple U1 TMKA75超宽带(UWB)芯片分析
最近发布的苹果iphone11系列手机中最有趣的组件之一是苹果很少提及的一个组件:苹果U1超宽带(UWB)芯片。到目前为止,苹果只表示该芯片可以实现定向功能
24
十月

TechInsights:iPhone11 Pro Max相机售价73.5美元
TechInsights公布了对苹果iPhone 11 Pro Max组件的评估。相机似乎是后昂贵的部分,73.50美元。
09
十月


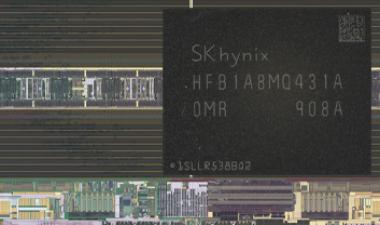
SK hynix 96L 3D PUC NAND分析
在全球范围内的储存制造商中,SK Hynix目前拥有NAND闪存市场份额的第5个职位,10.3%。它们是释放9倍层NAND解决方案的最新功能,使用SK Hynix 96L 3D PUC Nand。SK Hynix'96L 3D PUC的开发
27
九月

内置iphone11promax附带的苹果1720充电器
发布时间:2019年9月27日贡献作者:Sinjin Dixon-Warren iPhone 11 Pro Max船用Apple 1720 18 W USB-C电源输送充电器。该设备被额定交货5 V和3 A或9 V和2 A.在跟进我们最近的博客中
27
九月

苹果iphone11pro的拆卸对于STMicro和索尼来说是令人鼓舞的
意法半导体(STMicroelectronics)和索尼(Sony)似乎都在为苹果最新旗舰iphone提供四款芯片。许多其他历史上的iPhone供应商也出现在最新的拆分中。
26
九月

苹果iPhone 11 Pro Max拆卸
发布时间:2019年9月23日-更新时间:2019年10月1日投稿作者:Daniel Yang、Stacy Wegner、Albert Cowsky我们总是很兴奋地看到新的苹果iPhone,今年的iPhone 11系列也不例外。这是苹果有史以来的第一次活动
23
九月

Patent licensing: The patent battleplan
成功的、高回报的专利许可方案需要规划。TechInsights的Peter Hanschke提供了一个正确的指南。
23
九月

网络研讨会:准备许可证:使用工具扩展许可证计划
最初提交时间:2019年9月19日/美国东部时间12:00至下午1:00主办人:Martin Bijman Licensing是一种行之有效的专利组合货币化手段,但那些将在从专利所有权到专利利润的道路上取得成功的人将不会
19
九月

Micron Analysis Overview: LPDDR4 DDR4 3D NAND Flash and XPoint Reverse Engineered
发布日期:2019年9月17日,凭借2018年304亿美元的收入、NAND闪存16.5%的市场份额和DRAM 23%的市场份额,美光是存储和存储技术领域最大的参与者之一。对于那些希望支持其产品的人
17
九月
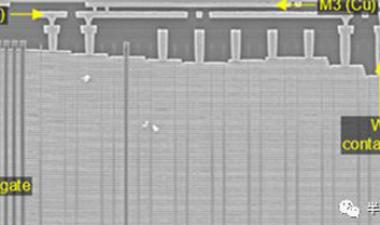

网络研讨会:电力半导体——市场概述和深入的SiC和GaN器件分析
上一篇广播:2019年9月10日星期二和2019年10月8日的星期二主持:建春徐和仙金迪克森 - 沃伦电力半导体市场估计到2025年底达到32亿美元。通过增加全球需求的推动
10
九月


佩洛顿IPO预告:全是炒作,没有肌肉
Peloton公司生产和销售高级、大屏幕、固定健身自行车和跑步机,以及针对使用这些设备的人的课程流媒体订阅,预计将在未来几个月的某个时候上市。
03
九月




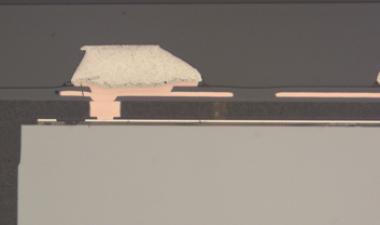
12月a Technologies Fan-In WLP in Qualcomm PM8150
发布时间:2019年8月29日,粉丝在WLP市场预计以稳定增长;2018年的2.9亿美元至44亿美元至2024美元,CAGR 6.5%。该市场的最近贡献者之一是Deca Technologies,其M系列扇出晶圆级包装
29
八月
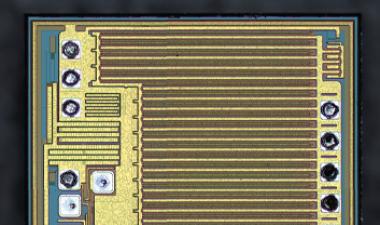
交流适配器中的GaN、SiC和Si技术
发布时间:2019年8月14日投稿作者:辛金·狄克逊·沃伦博士简介交流适配器不断提醒我们,我们所钟爱的移动设备并不像我们想象的那样移动。每个移动设备
14
八月

华为Mate 20 X(5G)拆卸中意外设计获胜
2019年是我们看到5G智能手机开始起飞的年。TechInsights在4月份发布了一款三星Galaxy S10 5G拆除的博客,这是世界上第一个韩国的5克手机。Galaxy S10 5G SM-G977N基于三星
02
八月

第4部分:非拜耳CFA,相位检测自动对焦(PDAF)
分为4部分的博客系列:智能手机成像器的最新技术第4部分:非拜耳CFA,相位检测自动对焦(PDAF)发布时间:2019年7月30日贡献作者:Ray Fontaine内容改编自TechInsights的国际图像论文
30
七月

第3部分:背部发光的活性Si厚度,深沟槽隔离(DTI)
分为4部分的博客系列:智能手机成像仪的最新技术第3部分:背光有源硅厚度,深沟隔离(DTI)发布时间:2019年7月23日贡献作者:Ray Fontaine内容改编自TechInsights的论文
23
七月

Velodyne激光雷达圆盘拆卸
发布日期:2019年7月22日根据国际清算银行的研究,2017年汽车激光雷达市场估计为3.53亿美元,预计到2028年将达到83.2亿美元。激光雷达市场将成为汽车行业最具竞争力的细分市场之一
22
七月

第2部分:像素缩放和缩放使能器
4-Part Blog Series: The state of the art of smartphone imagers Part 2: Pixel Scaling and Scaling Enablers Posted: July 16, 2019 Contributing Author: Ray Fontaine Content adapted from TechInsights’ paper for the International Image Sensors Workshop
16
七月


第1部分:芯片堆叠和芯片间互连
分四部分的博客系列:智能手机成像器的最新技术第1部分:芯片堆叠和芯片间互连发布时间:2019年7月9日投稿作者:Ray Fontaine内容改编自TechInsights的国际图像演示
09
七月

AMBIQ Micro Apollo 3蓝色超低功耗MCU
发布日期:2019年6月11日Ambiq Micro Apollo 3 Blue超低功耗MCU市场人满为患,竞争激烈,全球半导体公司在该技术领域的研发投入不断增加;预计2019年该市场将达到约200亿美元
10
六月
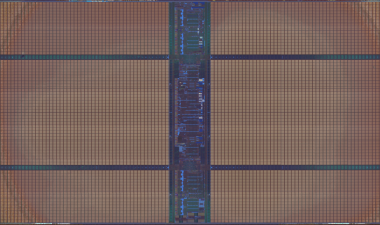
三星、SK hynix和Micron的1y DDR4 DRAM
发布日期:2019年6月7日三星LPDDR4X 17纳米1Y三星DDR4 17纳米1Y微米MT40A2G4SA-062E 8Gb DDR4三大DRAM制造商(三星、SK hynix和微米)在2017年和2018年推出1x,达到了20纳米以下。一个新的里程碑是
05
六月
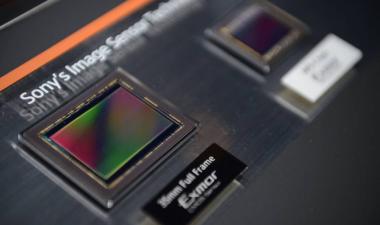
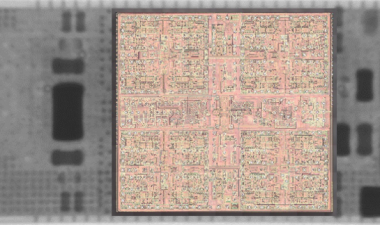
高通公司QTM052毫米波天线模块
发布时间:2019年5月31日高通公司QTM052毫米波天线模块高通公司声称,通过将毫米波技术整合到一个小型、高度集成的模块中的移动射频前端,实现了“不可能、可能”。有许多挑战
31
五月


网络研讨会:识别和追查专利侵权者-利用技术证据建立你的主张运动
在它的心中,断言活动依赖于使用的证据(EOU),以证明持续侵权的存在。如果没有人使用专利组合所涵盖的技术,那么您的专利并不那么有价值。相反,当有柜会时,专利组合的价值更大。
02
五月

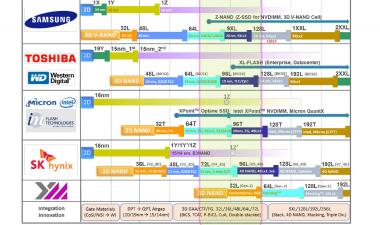
来自IEDM18的TechInsights内存技术更新
发布时间:2019年4月11日投稿作者:迪克·詹姆斯,赵正东去年周日晚上在IEDM,TechInsights举行了一个招待会,Arabinda Das和赵正东发表了演讲,吸引了一屋子与会者
11
四月

9X层3D NAND分析
发布日期:2019年4月10日TechInsights对三星、东芝和Intel/Micron TechInsights解决方案的分析已经开始,这些备受期待的9XL 3D NAND解决方案包括:三星92L 3D V-NAND和东芝96L 3D BiCS Intel/Micron 96L
10
四月

三星Galaxy S10 5G拆除
发布时间:2019年4月9日投稿作者:Daniel Yang&Stacy Wegner It's here。在我们的实验室里。。。上周发生了两件重大的5G事件:Verizon在芝加哥推出了他们的5G网络,而在地球的另一边,三星则推出了全球5G网络
09
四月
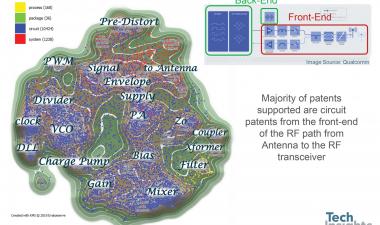

网络研讨会:高密度扇出封装技术-检查和比较
Originally Presented: April 9, 2019 / 2:00pm to 3:00pm ET Hosted By: Michel Roy Low-density fan-out package technology has been around for more than a decade. Due to limitations in RDL counts and capabilities in line space / line width, this
09
四月
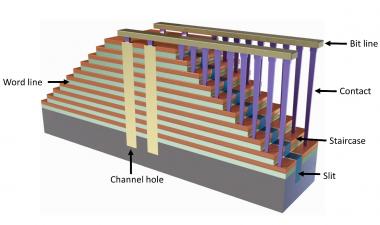


西门子的专利申请不断攀升,但质量胜于数量才是游戏的名称
2018年,西门子(Siemens)超越华为(Huawei)成为欧洲专利局(EPO)的头号备案商,这是自2011年以来,西门子从未占据过的一个位置。它投资了。。。
25
三月

三星Galaxy S10+拆卸
发布时间:2019年3月1日贡献作者:米歇尔·阿拉克,丹尼尔杨,Stacy Wegner,Albert Cowsky我们得到了新的三星Galaxy S10 +一点点!TechInsights从韩国收到Exynos三星Galaxy S10 + SM-G975F / DS,并已进入
01
三月

网络研讨会:移动射频领域
最初提交时间:2019年2月27日/3:00至4:00美国东部时间主持:John Sullivan A Patent and Technology Perspective我们估计移动射频(RF)市场价值约190亿美元。移动射频创新旨在提高
27
2月

联想将新的Snapdragon带到市场上
Posted: February 20, 2019 Contributing Authors: Stacy Wegner and Daniel Yang Lenovo Z5 Pro GT How long would it take you to count from 1 to 220,000? Probably longer than 32 seconds, and yet 32 seconds is reportedly how long it look for Lenovo to sell
20
2月

纳维在RAVPower RP-PC104-W氮化镓45 W USB C电源传输充电器内发现
发布时间:2019年2月7日投稿作者:Sinjin Dixon Warren,PhD Figure 1–RAVPower RP-PC104 USB-C充电器650 V氮化镓(GaN)功率高电子迁移率晶体管(HEMT)的主要新兴应用之一可能
07
2月

特斯拉准备将麦克斯韦的干电极创新应用于电池制造
发布时间:2019年2月7日投稿作者:Marty Bijman和Jim Hines图1-特斯拉的投资组合,包括麦克斯韦和SolarCity收购图2-特斯拉投资组合景观,显示哪些发明源自特斯拉、SolarCity和
07
2月

网络研讨会:寻找技术中使用的证据 - 善良,坏的和丑陋
最初提交时间:2018年12月12日/美国东部时间下午2:00至3:00主办人:Martin Bijman TechInsights已确定6000多项独特专利的使用证据(EoU)。在这样做的过程中,我们对专利的作用有了很大的了解
12
12月

网络研讨会:利用技术证据加强专利
最初提交时间:2018年10月23日/美国东部时间12:00至下午1:00主办人:Mary Lupul专利强化是一个术语,我们用来描述在起诉过程中可以应用的不同方法,以雷竞技会黑钱吗最大限度地发挥专利一旦生效的效用
23
十月

网络研讨会:优化专利起诉以实现更强大、更有价值的专利
最初提交时间:2018年10月4日/12:00 pm-1:00 pm EDT主办人:Martin Bijman&George Pappas专利强化是指在起诉期间从专利中实现最大潜在价值的过程-雷竞技会黑钱吗
04
十月

网络研讨会:将领先的STB,流设备和智能电视进行比较 - 设计和BOM视角
Originally Presented: September 18, 2018 / 2:00pm to 3:00pm ET Hosted By: Stacy Wegner With a significant cord-cutting trend, much has been said about how operators are reacting and modifying their offerings to retain subscribers tempted by streaming
18
九月

汽车专利:所有者,技术和调查EOU
最初呈现时间:2018年7月11日/美国东部时间下午2:00至3:00主持人:Jim Hines汽车行业正面临来自新市场进入者、新兴移动商业模式和消费者对汽车拥有态度变化的干扰。未来
11
七月

Creating Better Applications Through Patent Strengthening
雷竞技会黑钱吗专利强化是我们用来指在起诉过程中,甚至在专利被授予之前,从专利中获得最大潜在价值的过程。
20
六月
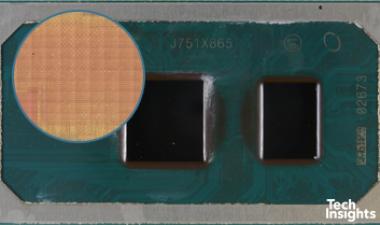
英特尔10 nm逻辑过程分析(Cannon Lake)
发布时间:2018年6月12日英特尔10nm逻辑流程分析TechInsights已找到已久的大炮湖 - I3-8121U CPU内的英特尔10nm逻辑流程,用于Lenovo Ideapad330。这项创新拥有以下内容:逻辑晶体管
12
六月

SK hynix 72L 3D NAND分析
发布时间:2018年5月31日SK hynix 72L 3D NAND Analysis SK hynix声称已经创造了业界第一个72层256Gb 3D NAND闪存。与48层3D TLC芯片相比,这种创新的块大小大了50%,编程时间更短
31
五月

网络研讨会:黑匣子揭示-在具有挑战性的产品领域调查专利技术
最初呈现:2018年5月3日至3:15 PM至4:00 PM ET主持:Martin Bijman“黑匣子揭示”是我们用来指的“硬质品” - 技术,这是一个原因或另一个难以分析使用证据。这些可以
03
五月

优步专利景观是什么样的?
发布时间:2018年2月27日供稿作者:Marty Bijman最近,IAM的Timothy Au发布了一篇博客,介绍了Uber的投资组合。该博客引用了Uber的投资组合构成,并提供了过去5年中他们的IP事件的历史记录
27
2月

网络研讨会:2018年及以后的公司的专利组合货币化关键考虑因素
最初提交时间:2018年2月20日/美国东部时间下午3:00至5:00主办人:Martin Bijman&George Pappas专利强化是指在起诉期间从专利中实现最大潜在价值的过程-雷竞技会黑钱吗
20
2月

网络研讨会:释放软件专利的价值-技术视角
最初提交时间:2018年2月1日/12:00 pm-1:00 pm作者:Mike McLean、Gene Quinn&Walter Hanchuk Alice对软件专利产生了影响,但它们可以而且仍然具有重要价值。如果你的投资组合包括软件
01
2月


Job Vacancy: VP, Financial Controller
作为财务副总裁向首席财务官汇报工作,你将领导财务团队成员负责日常会计、工资、税务和财务、报告、计划、预算和法定文件。你要管理公司
11
九月

职位空缺:软件开发人员
我们目前正在寻找一个完整的堆栈软件开发人员加入我们的科罗拉多州TechInsights平台开发团队之一。你对解决复杂有趣的问题有热情吗?你每天都努力学习新东西吗?你…吗
11
九月

Job Vacancy: Sales Representative
内部销售代表是上市销售团队的关键成员。在与外部销售和市场团队的密切合作下,你将负责跟进潜在客户,同时确定新的业务或销售
10
九月

Job Vacancy: VP, Sales Operations
由于我们的发展,我们现在正在招聘一名个人来领导我们的销售运营职能,并通过支持我们的公司目标和目的进一步发展业务,包括但不限于:报告、分析、业务
09
九月





